- - Philips (PANalytical) X'Pert PRO MPD
- - X-ray Diffraction (XRD) is a powerful nondestructive technique for characterizing crystalline materials. It provides information on structures, phases, preferred crystal orientations (texture), and other structural parameters, such as average grain size, crystallinity, strain, and crystal defects.
|
- - Identification/quantification of crystalline phase including thin film phase analysis (grazing incidence XRD)
- - Standardless quantification (Rietveld refinement)
- - Quantification of preferred orientation (texture) in thin films, multi-layer stacks, and manufactured parts
- - X-ray Reflectance (XRR) – Thickness and surface roughness of thin films (2nm – 1mm)
- - Measurement of average crystallite size, strain, or micro-strain effects in bulk and thin-film samples
- - Determination of lattice parameters to quantify alloy content
|
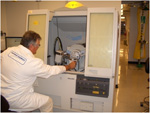
- - Elements Detected:
All elements, assuming they are present in a crystalline matrix Hot stage range (23-100oC) Accepts large and small organic/inorganic bulk samples, powders, metals, thin films, plastics, polymers. Large samples must be able to fit on 8" circular stage
- - Detection Limits:
Resolution = 0.001° Quantitative multiphase analysis: ~1% External standard quantitative analysis: ~0.1% Minimum film thickness for phase identification: ~20 Angstroms
- - Depth Resolution:
Adjustable sampling depth between ~20 Angstroms to ~30 microns, depending on material properties and x-ray incidence angles Lateral Resolution/Probe Size:Point focus: 0.25mm x 0.5mm Line focus: 2mm to 12 mm
|


 Instrument Range (1 g sample)
Instrument Range (1 g sample)
 Sample Type:
Sample Type: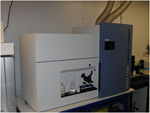 Uses inductively coupled plasma to generate excited atoms which emit element-specific radiation. This radiation is diffracted into its spectral components in the optical system. A diode array of semiconductor detectors (CCDs) provides simultaneous measurement of emission intensities, which are in turn converted into element concentrations by the Ciros Vision's dedicated Smart Analyzer software.
Uses inductively coupled plasma to generate excited atoms which emit element-specific radiation. This radiation is diffracted into its spectral components in the optical system. A diode array of semiconductor detectors (CCDs) provides simultaneous measurement of emission intensities, which are in turn converted into element concentrations by the Ciros Vision's dedicated Smart Analyzer software. 
 Argon plasma torch operates at 6000 K to generate population of singly-charged atoms which are passed through sampling and skimming cones into a 10-5 torr vacuum chamber. Ions are passed through a voltage-controlled ion lens into a quadrapole mass spectrometer that continually rasters across the entire elemental mass range. The ions are detected by a dual-range ETP detector having sensitivity from a few counts/sec to millions of counts/sec, allowing a dynamic range that extends from ppt to ppm. The TotalQuant Application allows for rapid semi-quantitation of most elements in the periodic table and automatically corrects for spectral interferences. The Quantitative Analysis application allows for rapid simultaneous quantitation of selected elements.
Argon plasma torch operates at 6000 K to generate population of singly-charged atoms which are passed through sampling and skimming cones into a 10-5 torr vacuum chamber. Ions are passed through a voltage-controlled ion lens into a quadrapole mass spectrometer that continually rasters across the entire elemental mass range. The ions are detected by a dual-range ETP detector having sensitivity from a few counts/sec to millions of counts/sec, allowing a dynamic range that extends from ppt to ppm. The TotalQuant Application allows for rapid semi-quantitation of most elements in the periodic table and automatically corrects for spectral interferences. The Quantitative Analysis application allows for rapid simultaneous quantitation of selected elements.  Sample Type:
Sample Type:
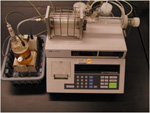
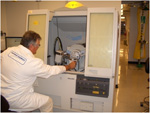
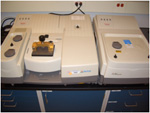
 Spectral Ranges:
Spectral Ranges:

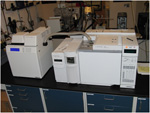 HP 6890N GC and G1888 Head Space Analyzer
HP 6890N GC and G1888 Head Space Analyzer 

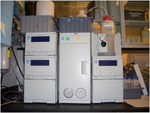


 Gas
Gas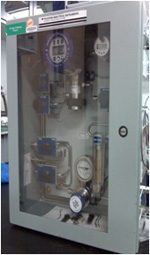 Gas
Gas
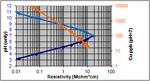




 Particle and molecule sizes from below a nanometer to several microns Temperature range (°C): 0 - 90
Particle and molecule sizes from below a nanometer to several microns Temperature range (°C): 0 - 90 

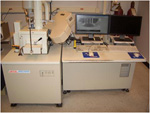
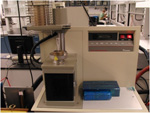
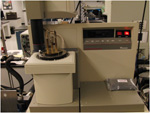
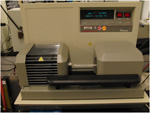
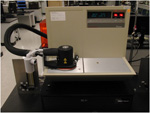

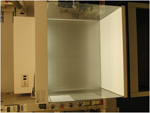
 Balances
Balances  Balance Max (grams) Precision (mg)
Balance Max (grams) Precision (mg) Magnifications:
Magnifications: Samples must have a low moisture and oxygen content.
Samples must have a low moisture and oxygen content.